Mikä on palloverkon taulukko (BGA)?Edut, tyypit, kokoonpanoprosessi
2025-08-25
11696
Luettelo

Kuva 1. Palloverkkoaryhmä (BGA)
Mikä on palloverkon taulukko (BGA)?
BGA- tai palloverkkoaryhmä on tyyppinen sirupakkaus, jota käytetään integroiduiden piirien (IC) kytkemiseen suoraan painettuun piirilevyyn (PCB).Tappien sijasta BGA: lla on monia pieniä juotospalloja, jotka on järjestetty verkkoon alapuolella.Lämmitettäessä nämä juotospallot sulavat ja kiinnittävät sirun levyyn, jolloin muodostuu sekä fyysinen sidos että sähköliitännät.Koska koko alapintaa käytetään liitännäihin, BGA: t mahtuvat pieneen tilaan paljon enemmän liitäntöjä vanhemmiin PIN-pohjaisiin paketteihin verrattuna.
BGA: t voivat myös paremmin kuljettaa sähkösignaaleja nopeasti ja levittää lämpöä, joten siru voi ajaa nopeammin ja pysyä viileämmänä.BGA: ta käytetään laajasti nykyaikaisissa laitteissa, kuten mikroprosessorit, näytönohjaimet ja muissa korkean suorituskyvyn elektroniikassa, jossa tarvitaan kompakti kokoa, nopeutta ja luotettavuutta.
Kuinka palloverkon taulukko (BGA) -paketit toimivat
Ball Grid -ryhmä (BGA) toimii käyttämällä sirun pohjassa olevia pieniä juotospalloja yhdistääksesi sen tulostettuun piirilevyyn (PCB).Jokainen juotospallot vastaavat pienellä tyynyllä pöydällä.Kun siru asetetaan pöydälle ja lämmitetään erityisessä uunissa, juotospallot sulavat ja tarttuvat tyynyihin.Jäähdytyksen jälkeen juotos muuttuu jälleen kiinteäksi, luomalla vahvoja sähköpolkuja ja pitämällä sirua tiukasti paikoillaan.Yksi älykäs asia BGA: ssa on, että sulatettu juote auttaa sirua "itsehallinnosta".Tämä tarkoittaa, että siru voi säätää itsensä oikeaan asentoon lämmityksen aikana, mikä vähentää virheitä, joita tapahtuu vanhempien PIN-pohjaisten sirujen kanssa.
Juotospallot leviävät tasaisesti, signaalit kulkevat nopeammin, melu vähenee ja lämpö siirtyy levylle sirun jäähdyttimen pitämiseksi.Ja koska juotosliitokset on piilotettu sirun alle, niitä ei voida nähdä suoraan.Jotta voidaan tarkistaa, ovatko yhteydet hyvät, tarvitaan erityisiä työkaluja, kuten röntgenlaitteita.Jos ongelma tapahtuu, BGA -sirun korjaaminen tai vaihtaminen vaatii erityisiä laitteita, mikä vaikeuttaa korjausta kuin vanhemmat paketit.
Miksi valita Ball Grid Array (BGA) -paketit

Kuva 2. Ball Grid -ryhmä (BGA) alaosa
Ball Grid Array (BGA) -paketit ovat suositeltavia, koska ne ratkaisevat monia vanhemmista sirumallit, kuten Quad Flat -pakkaukset (QFP).QFPS: ssä siru yhdistyy levyyn erittäin ohuiden tapien läpi, jotka on sijoitettu tarkkaan reunoja pitkin.Nämä nastat voivat taipua tai rikkoa helposti, mikä tekee korjauksista kovia ja kalliita.Kapea etäisyys lisää myös juotosten aikana virheiden riskiä, kuten nastat, jotka koskettavat toisiaan ja aiheuttaen piirin epäonnistumisen.Lisäksi tungosta nastat vaikeuttavat painetun piirilevyn (PCB) suunnittelun, koska kaikkien niiden ympärillä olevien polkujen reitittäminen johtaa tukkeutumiseen ja suorituskykyyn.
BGAS ratkaisee nämä ongelmat käyttämällä pieniä juotospalloja sirun alapuolella herkän nastan sijasta.Nämä juotospallot ovat vahvempia ja vähemmän todennäköisesti vaurioituneita, samalla kun ne antavat enemmän vapautta piirilevyn suunnittelussa, koska yhteydet levitetään koko pohjapinnalle.BGA: n itsenäinen ominaisuus tekee prosessista yksinkertaisemman ja parantaa yhteyden yleistä laatua.Näistä syistä BGA -paketeista on tullut vakio ja paras valinta nykyaikaisessa elektroniikassa.
Ball Grid Array (BGA) -pakettien edut
• Lisää yhteyksiä pienissä tiloissa - BGA: t käyttävät sirun koko pohjaa juotospalloille, ei vain reunoille.Tämä sallii monia yhteyksiä tekemättä sirua suuremmaksi.
• Parempi signaalin suorituskyky - BGA: n juotospallot ovat lyhyitä ja leveitä, mikä tekee signaalien polun sileämmäksi.Tämä vähentää ongelmia, kuten viive, vastus ja häiriöt.Tämä auttaa sirua toimimaan paremmin ja luotettavasti.
• Hyvä lämmönhallinta - Sirut voivat kuumentua hyvin, kun ne juoksevat nopeasti.BGA: t auttavat levittämään lämpöä tasaisesti piirilevyyn, ja levy kantaa lämmön pois.Tämä pitää sirun jäähdyttimen ja antaa sen toimia suuremmilla nopeuksilla ilman ylikuumenemista.
• Vahvat ja luotettavat nivelet - Vanhan tyylin nastat voivat taivuttaa, rikkoa tai aiheuttaa ongelmia juottamisen yhteydessä.BGA: lla ei ole tätä asiaa, koska juotospallot ovat vahvempia eivätkä taipu.Lämmitettyä juotos sulaa ja vetää sirun oikeaan paikkaan, mikä tekee yhteydestä turvallisemman ja pitkäaikaisen.
• Helpompi piirilevyn suunnittelu - Koska pallot levitetään sirun alle, piirilevy on vähemmän tungosta.Tämä helpottaa virheiden suunnittelua ja vähentää.
• Pieni ja kevyt - BGA -paketit ovat pienempiä ja kevyempiä verrattuna vanhempiin malleihin, kuten QFP.Tämä tekee niistä erinomaisia kannettavia laitteita, kuten kannettavia tietokoneita, tablet -laitteita ja älypuhelimia, joissa tarvitaan tilaa ja painoa.
Palloverkon taulukko (BGA)
Palloverkkoaryhmiä on monen tyyppisiä, joista kukin on valmistettu erityistarpeista, kuten koko, lämmönhallinta, kustannukset tai suorituskyky.Alla on yleisimmät niiden pääpiirteet ja lyhyet kuvaukset:
Nauhan palloruudukko (TBGA) - Tämä tyyppi käyttää ohutta nauhan kaltaista pohjaa tukemaan siru- ja juotospalloja.TBGA on kevyt, joustava ja hallitsee lämpöä hyvin, joten se sopii kompaktiin elektroniikkaan, jossa tarvitaan tilaa ja jäähdytystä.
Parannettu palloverkon taulukko (EBGA) - Orgaanisten ja keraamisten materiaalien sekoituksella valmistettu EBGAS tarjoaa voimakkaan lämpöhallinnan, luotettavan signaalin virtauksen ja kiinteän mekaanisen lujuuden.Ne valitaan vaatimaan sovelluksia, kuten prosessoreita ja grafiikkayksiköitä.
Metallipalloverkon taulukko (MBGA) - MBGA: t toimittavat emäksenä metallikorkean ytimen erinomaisen kestävyyden ja lämmön leviämisen.Ne ovat parasta ympäristöille, joihin liittyy raskaita lämpökuormia tai jotka vaativat lisää vakautta.
Muovipalloverkon taulukko (PBGA) - PBGA: t käyttävät muovipohjaa, pitäen ne kevyinä ja kustannusystävällisinä.Ne ovat suosittuja kuluttajavälineissä, autojärjestelmissä ja televiestintälaitteissa, koska ne tasapainottavat hintaa luotettavan suorituskyvyn kanssa.
Keraamiset palloruudukon taulukko (CBGA) - CBGA: t luottavat keraamiseen pohjaan, joka tarjoaa korkean vakauden ja luotettavuuden ääriolosuhteissa.CBGA: ta käytetään ilmailu-, puolustus- ja lääketieteellisissä laitteissa, joissa kestävä kestävyys on välttämätöntä.
Valettu ryhmäprosessi BGA (MAPBGA) - Tämä vaihtoehto on taloudellinen ja kompakti, joka on suunniteltu laitteille, jotka tarvitsevat luotettavaa toimintaa, mutta ei äärimmäistä suorituskykyä.MAPBGA on käytännöllinen matalan ja keskitason elektroniikassa pienen koon ja yksinkertaisen asennusprosessinsa vuoksi.
Lämpöparannettu PBGA (TEPBGA) - Lisäämällä paksut kuparitasot pohjaan, TEPBGA: t voivat vetää lämpöä nopeasti pois.Ne ovat ihanteellisia siruille, jotka tuottavat paljon lämpöenergiaa ja tarvitsevat tehokasta jäähdytystä.
Paketti paketissa (pop) - Pop -tekniikka pinotaan useita siruja päällekkäin, kuten muistin sijoittaminen prosessorin yläpuolelle.Tämä säästää tilaa ja lisää toiminnallisuutta, mikä on erityistä älypuhelimissa ja tableteissa.
Mikro BGA (µBGA) - Tämä miniatyyriversio on rakennettu erittäin hienoilla sävelkorkeilla, joskus alle 1 mm.µBGA on suunniteltu erittäin pienille laitteille, kuten puettaville ja muille erittäin kompakteille elektroniikalle.
Palloverkon taulukko (BGA) kokoonpanoprosessi
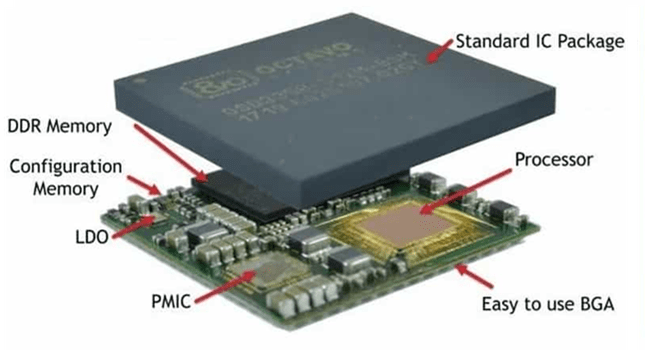
Kuva 3. BGA -pakkaus ja komponenttien asettelu
Kun BGA-paketteja otettiin ensimmäisen kerran käyttöön, monet ihmiset ovat huolissaan siitä, kuinka ne kootavat, koska yhteydet on piilotettu sirun alle, toisin kuin vanhemmat pinta-asennepaketit, joissa on näkyviä tapia.Aluksi tämä herätti epäilyksiä heidän luotettavuudestaan, mutta pian todistettiin, että reflw -juotos toimii erittäin hyvin BGA: ien kannalta.
Tässä prosessissa koko piirilevy, mukaan lukien BGA, lämmitetään hallitulla tavalla.Sirun alla olevat juotospallot on jo päällystetty oikealla juotosmäärällä, ja kun lämpötila nousee, ne sulavat ja muodostavat voimakkaita yhteyksiä pöydän tyynyihin.Luonnollinen vaikutus, jota kutsutaan pintajännitykseksiKun juote jäähtyy, se pysyy lyhyesti osittain nestemäisenä, mikä antaa jokaisen pallon asettua kunnolla koskettamatta naapurejaan.Huolellinen lämpötilanhallinta ja oikea juotoslejeerari takaa luotettavia ja erillisiä niveliä.
Lopulta tätä prosessia on parannettu ja standardisoitu, joten BGA -kokoonpano on nyt iso osa elektroniikan valmistusta.Nyt BGA: ta pidetään luotettavina, tarkkoina ja tehokkaina paketteina, jotka auttavat luomaan kompakteja ja tehokkaita elektronisia laitteita.
Ball Grid Array (BGA) -pakettien sovellukset
Ball Grid Array (BGA) -paketit ovat yleisiä nykypäivän elektroniikassa, koska ne antavat vahvojen sirujen mahtua pieniin tiloihin ja toimia silti hyvin.Alla on palloverkon taulukon sovellukset:
Mikroprosessorit ja suorittimet - Tarjoa nopea käsittely ja luotettava suorituskyky tietokoneissa, palvelimissa ja sulautetuissa järjestelmissä.
Grafiikkaprosessorit (GPU) - Käsittele suuria määriä tietoja ja lämpöä pelikonsolissa, kannettavissa tietokoneissa ja graafisissa korteissa.
Muistilaitteet - Käytetään RAM -muistiin, flash -muistissa ja muissa tallennusmoduuleissa säästämään levyn tilaa pitäen suorituskyvyn korkeana.
Kulutuselektroniikka - löytyy älypuhelimista, tabletteista, kannettavista tietokoneista ja älytelevisioista, joissa tarvitaan kompakti kokoa ja tehokkuutta.
Televiestintälaitteet - Varmista nopea ja vakaa signaalinsiirto verkkojärjestelmissä ja viestintälaitteissa.
Autoteollisuusjärjestelmät - Tukea edistyneitä kuljettajan avustamisjärjestelmiä (ADAS), infotainment- ja ohjausmoduuleja, joilla on luotettavia yhteyksiä.
Lääketieteelliset laitteet - Käytetään laitteissa, jotka vaativat tarkkuutta ja kestävyyttä, kuten kuvantamisjärjestelmät ja seurantatyökalut.
Ilmailu- ja puolustus - Tarjoa voimakas lämpö- ja mekaaninen vakaus ankarissa ympäristöissä.
Common Ball Grid Array (BGA) -kysymykset ja ratkaisut
Murtuneet nivelet - Halkeamia voi muodostua juotospalloissa toistuvan lämmityksen ja jäähdytyksen vuoksi tai mekaanisesta jännityksestä, kuten taivutusta tai tärinää.Käytä voimakkaampia juotosseoksia, lisää alustot materiaaleja tukia varten ja suunnittelulaudat, jotka vähentävät mekaanista rasitusta.
Heikot juotosliitokset - Jos juotos ei sulaa täysin reflörin aikana, nivel voi olla heikko ja aiheuttaa huonoja yhteyksiä.Hallitse palautuslämpötilaa huolellisesti ja varmista, että oikea juotospasta -määrä on käytetty.
Sillas - Kun juotospallot sulavat yhteen, ne voivat luoda oikosulkuja yhteyksien välillä.Levitä oikea juotos liitän paksuus, pidä juotospallot tasaisesti etäisyydellä ja seuraa tarkkoja lämmitysprofiileja.
Tyhjät (ilmataskut) - Ilmataskut tai kaasut voivat juuttua juotosen sisälle, mikä tekee nivelistä heikompia ja vähemmän luotettavia.Käytä asianmukaista juotospasta, puhdista piirilevypinta -kaivo ja optimoi reflow -prosessi loukkuun jääneen kaasun vähentämiseksi.
Väärinkäyttö - Jos sirua ei sijoiteta oikein, juotospallot eivät välttämättä vastaa piirilevyjä.Käytä automatisoituja poiminta- ja paikkalaitteita ja anna itsenäisyyden siirtäminen palautuslämmityksen aikana.
Vaikea tarkastaa tai korjata - Koska BGA -nivelet ovat piilossa pakkauksen alla, on vaikea nähdä ongelmia ja vielä vaikeampaa korjata niitä.Tarkista röntgentarkastus juotosliitoksien ja erityisten uusintatyökalujen viallisten BGA: ien poistamiseksi ja korvaamiseksi.
BGA vs. muut IC -pakkaustekniikat
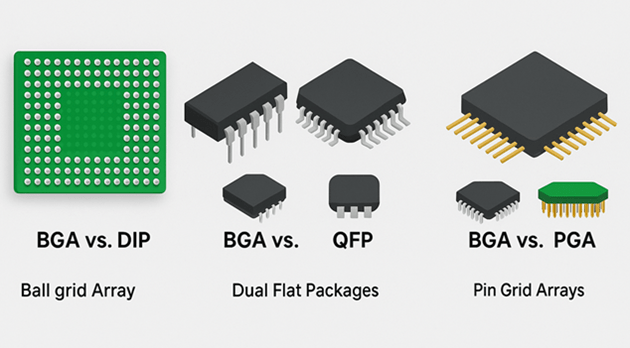
Kuva 4. BGA vs. muut IC -pakkaukset
BGA vs. DIP
Dual-linjapaketeissa (DIP) on kaksi riviä napoja sirun sivuilla.Ne ovat halpoja, helppokäyttöisiä ja hyviä yksinkertaiseen elektroniikkaan, mutta ne vievät enemmän tilaa eivätkä pysty käsittelemään monia yhteyksiä.Ball Grid Array (BGA) -piirit käyttävät pakkauksen alla olevia pieniä juotospalloja, mikä sallii paljon enemmän yhteyksiä pitäen sirun pienempi.Tämä tekee BGA: t paremman nykyaikaiselle elektroniikalle, jossa säästäminen on välttämätöntä.
BGA vs. QFP
Quad Flat Packages (QFP) Käytä ohuita nastaa, jotka on sijoitettu lähelle toisiaan reunojen ympärille.Nämä nastat taipuvat helposti ja voivat aiheuttaa ongelmia juottamisessa, koska ne ovat niin lähellä, että ne saattavat koskea vahingossa, mikä johtaa oikosulkuihin.BGA: t välttävät tätä asettamalla juotospallot sirun alle nastajen sijasta.Pallot ovat vahvempia, leviävät pohjaan ja rivittävät oikein lämmityksen aikana, mikä antaa luotettavampia yhteyksiä.
BGA vs. PGA
Pin -ruudukkojärjestelmät (PGA) on pohjasta tarttuva tappiverkko, joka kytketään levylle.Niitä on helppo poistaa ja korvata, mutta nastat voivat taipua tai rikkoa käsiteltäessä.BGAS kytketään suoraan levylle käyttämällä juotospalloja nastajen sijasta.Tämä tekee yhteyksistä tiukempia, parantaa lämmön virtausta ja auttaa signaaleja liikkumaan nopeammin, mikä tarvitaan tehokkaisiin prosessoriin ja grafiikkalastuihin.
Johtopäätös
BGA: ta käytetään nykyään laajalti, koska ne sopivat moniin yhteyksiin pieneen tilaan, parantavat lämmönhallintaa ja antavat paremman suorituskyvyn.Vaikka niitä on vaikeampi tarkistaa ja korjata, heillä on luotettavasti oikeat työkaluja.Puhelimista ja kannettavista tietokoneista autoihin ja lentokoneisiin BGA: iin luotetaan laitteiden pienempiin, vahvempiin ja tehokkaampiin.
 MEISTä
Asiakastyytyväisyys joka kerta.Keskinäinen luottamus ja yhteiset edut.
MEISTä
Asiakastyytyväisyys joka kerta.Keskinäinen luottamus ja yhteiset edut.
toimivuustesti.Suurimmat kustannustehokkaat tuotteet ja paras palvelu ovat iankaikkinen sitoutumisemme.
Kuuma artikkeli
- LM358 Dual Operatiivinen vahvistin Kattava opas: Pinoutit, piirikaaviot, ekvivalentit, hyödylliset esimerkit
- Ovatko CR2032 ja CR2016 vaihdettavissa?
- Ymmärtäminen ESP32- ja ESP32-S3: n teknisten ja suorituskykyanalyysien ymmärtäminen
- Oikean akun valitseminen: Opas AG4: lle, LR626, LR66, 177/376/377, SR626 ja SR626SW -vastaavat
- NPN vs. PNP: Mikä ero on?
- BC547-transistorin perusteet: Pinout, sovelluspiirit, vaihtoehtoiset/täydentävät mallit
- ESP32 vs STM32: Mikä mikrokontrolleri on sinulle parempi?
- Mikä on MOSFET ja miten se toimii?
- Sähköreleen perustiedot: työtoiminta, tyypit ja käyttötarkoitukset
- PNP -transistorit: rakenne, työperiaate ja sovellus
 IC 7400: n tutkiminen: tekniset tiedot, PIN -kokoonpanot ja käytännön sovellukset
IC 7400: n tutkiminen: tekniset tiedot, PIN -kokoonpanot ja käytännön sovellukset
2024-09-09
 Kattava opas virransyöttöpiireihin
Kattava opas virransyöttöpiireihin
2024-09-06
Usein Kysytyt Kysymykset [FAQ]
1. Mikä on BGA -paketin elinikä?
BGA-paketti voi kestää 10-20 vuotta normaaleissa olosuhteissa riippuen kokoonpanon laadusta ja ympäristöstä, jossa se toimii. Lämpöjaksot, värähtely ja huonot juotoskäytännöt voivat lyhentää sen käyttöikää, etenkin korkean stressisovellusten, kuten autojen tai ilmailualan elektroniikan,.
2. Voidaanko BGA -sirut korvata tai muokata uudelleen?
Kyllä, mutta se vaatii edistyneitä työkaluja ja taitoja.Erikoistuneita laitteita, kuten kuuma-ilma-asemia ja röntgentarkastusjärjestelmiä, käytetään vanhan sirun poistamiseen, levyn puhdistamiseen ja uuteen juottamiseen paikallaan.
3. Miksi BGA: t ovat vaikeampi korjata kuin QFP: t?
QFP: ssä nastat ovat näkyviä ja ne voidaan tarvittaessa myydä manuaalisesti.BGA: t piilottavat juotosliitoksensa paketin alle, mikä tekee visuaalisesta tarkastuksesta ja korjata paljon monimutkaisempia ja aikaa vieviä.
4. Mitä tapahtuu, jos BGA -juotosliitokset epäonnistuvat?
Epäonnistunut juotosliitokset voivat aiheuttaa laitteen näyttämään satunnaisia virheitä, menettämään suorituskyvyn tai lopettamaan toiminnan kokonaan.Useimmissa tapauksissa siru on palautettava uudelleen tai vaihdettava koko toiminnon palauttamiseksi.
5. Kuinka BGA: n uudelleenpallo tehdään?
Uudelleenpalloitukseen kuuluu vanhojen juotospallojen poistaminen, pinnan puhdistaminen ja uusien pallojen levittäminen kaavaimella.Sitten paketti lämmitetään reflörisissä uunissa, jotta uudet pallot kiinnitetään tiukasti siruun.
Kuuma osanumero
 C1608X7R1H474K080AC
C1608X7R1H474K080AC K104K15X7RF5TL2
K104K15X7RF5TL2 C2012X6S1V155M125AB
C2012X6S1V155M125AB C1005CH1H681J050BA
C1005CH1H681J050BA EMK212ABJ225KD-T
EMK212ABJ225KD-T 1206ZD226MAT2A
1206ZD226MAT2A 0201YC102MAT2A
0201YC102MAT2A 12065A240FAT2A
12065A240FAT2A TPSB475M025Y1500
TPSB475M025Y1500 TAP156M006SRW
TAP156M006SRW
- TAP686K016HSB
- T496X226K025AS
- VT200F-12.5PF20PPM
- CY2318ANZPVXC-11
- TC58BVG0S3HTAI0
- LNK304DN-TL
- PIC16F1789-I/MV
- BSM400GA120DLCFS
- TT215N18KOF
- MC33368DG
- XC4003E-1PC84C
- LT1330CG#PBF
- AD8617WARMZ-REEL
- LT1171IQ#TRPBF
- MC3487DRG4
- AD9066JR-REEL
- AM5D5808FEQSBG
- BR24C02F-WE2
- BSC014N03LSG
- CYDMX128B16-55BVXI
- EP1C20F400I-6
- LM2645MTD
- M30302GCP-055FP
- MC33363DWR2G
- MC68HC711E9CFNE
- PEX8714-AB80BIG
- PMDPB58UPE
- SC370677FN
- TLP3216
- ZMM5233B
- RFP100-50TW
- S34Ml04G200BHI00
- 39VF160270-4C-EKE
- MX636JCWE
- URB2412LD-20WR3
- XC2S100-3FG256I
- 7847110020
- MAX17613AATP+T
- HR10-7R-CDUSTCAP